令和5年度全国発明表彰 受賞発明・意匠概要(敬称略)
(第一表彰区分一覧へ/第二表彰区分一覧へ)
日本経済団体連合会会長賞
動的統計しきい値を用いた半導体接合欠陥の高感度超音波検査装置の発明(特許第6546826号)
| 酒井 薫 | 株式会社日立製作所 サステナビリティ研究統括本部 コネクティブオートメーションイノベーションセンタ AI制御研究部 主任研究員 | |
| 菊池 修 | 元 株式会社日立パワーソリューションズ パワー・産業ソリューション本部 産業ソリューション部 | |
| 佐原 健司 | 株式会社日立パワーソリューションズ 営業統括本部 産業営業統括部 生産システム営業部 |
発明実施功績賞
| 安藤 次男 | 株式会社日立パワーソリューションズ 取締役社長 |
本発明は、半導体やMEMS等の積層ウェハを対象とした超音波検査装置に関するものである。
電子部品の製造現場では、信頼性確保のため、内部に潜む接合欠陥の超音波検査が必要不可欠である。一方、回路パターンは微細化と、ウェハを積層して実装する3次元化が急速に進み、検査装置には、より微小な欠陥をウェハの状態で検出する要求が高まっていた。
本発明は、ウェハ内に同一品種のチップが複数形成されることを利用し、ウェハ接合面の超音波画像より、統計処理に基づき、Φ10µm程度の欠陥を、製造公差内で変動する回路パターンの形状ばらつきと分離して検出するとともに、ウェハ内部の欠陥発生分布の可視化を実現した。
本発明による超音波検査装置は、国内外の主要な電子部品メーカに広く採用されている。欠陥発生分布の解析により、不具合プロセスを特定し、プロセス条件の改善を迅速に行うことが可能となり、電子部品の安定供給に貢献している。
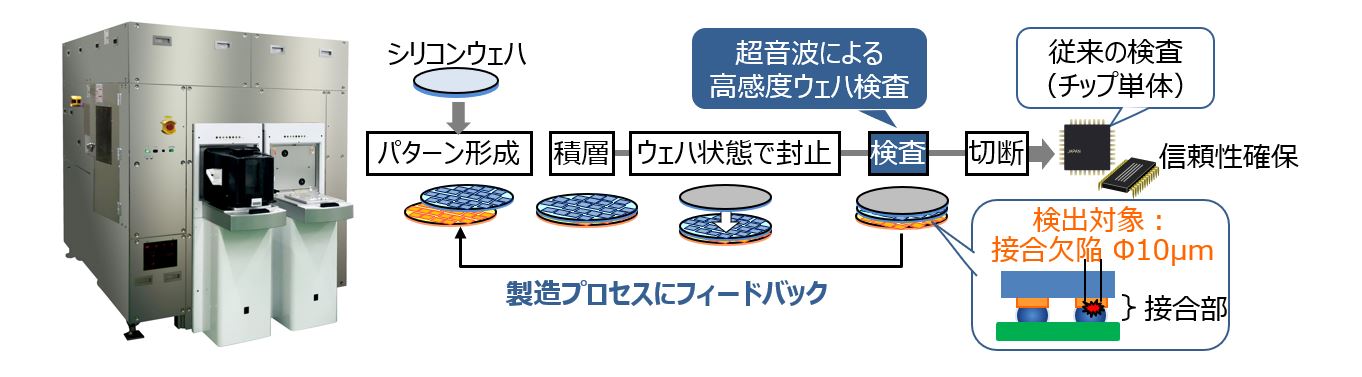 |
| 図1 本発明を搭載した超音波検査装置の概観と位置づけ |
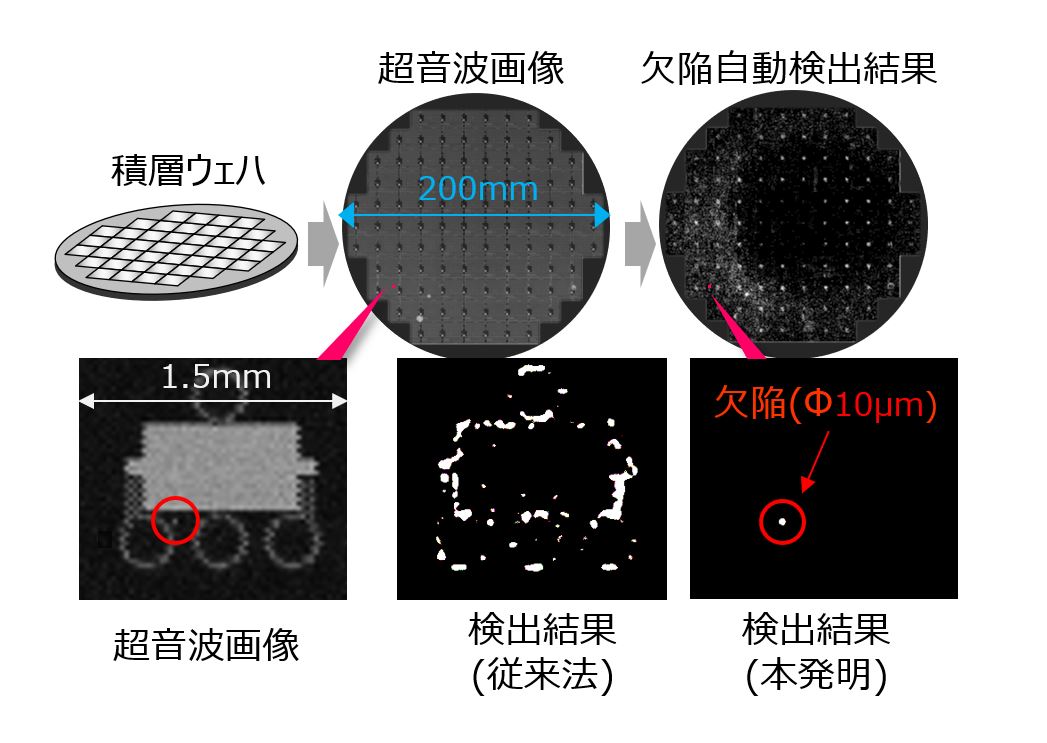 |
| 図2 本発明による欠陥自動検出結果の例 |
















